Chipfabrikant GlobalFoundries heeft een testchip ontwikkeld die de TSV-techniek van het bedrijf demonstreert. Met die Through Silicon VIA-technologie moeten chips op elkaar gestapeld kunnen worden.
Het stapelen van chips moet kleinere chippackages tot gevolg hebben. Het wordt nu ook al toegepast, maar wordt dan alleen met losse chips gerealiseerd. De verbindingen lopen daarbij extern en zijn relatief traag. Het gebruik van Through Silicon Vertical Interconnect Access's, waarbij interconnects als tunnels door de verschillende plakjes silicium van de gestapelde chips lopen, levert door de kortere afstanden en een groter aantal verbindingen betere prestaties. GlobalFoundries heeft deze technologie gedemonstreerd met 20nm-chips.
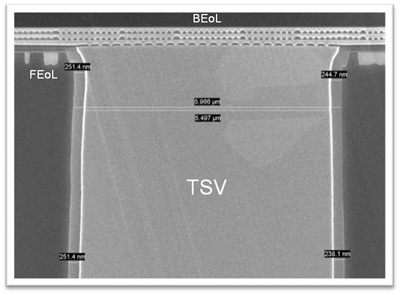 Met de TSV's wil GlobalFoundries zogeheten 3d-chips op 20nm mogelijk maken. Daarbij zouden verschillende types chips, zoals flashgeheugen, werkgeheugen en rekencores gecombineerd kunnen worden. GlobalFoundries heeft sram-dies met elkaar verbonden, waarbij de 20nm 3d-chips evengoed werkten als losse 20nm-chips. De testchips van GlobalFoundries zouden de eerste werkende chips met TSV's op 20nm zijn.
Met de TSV's wil GlobalFoundries zogeheten 3d-chips op 20nm mogelijk maken. Daarbij zouden verschillende types chips, zoals flashgeheugen, werkgeheugen en rekencores gecombineerd kunnen worden. GlobalFoundries heeft sram-dies met elkaar verbonden, waarbij de 20nm 3d-chips evengoed werkten als losse 20nm-chips. De testchips van GlobalFoundries zouden de eerste werkende chips met TSV's op 20nm zijn.
Een door GF ontwikkelde techniek om de contacten van de koperen interconnects te beschermen moet het toevoegen van TSV's aan de eerder ontwikkelde 20nm-productiemethodes relatief eenvoudig maken. De volgende stap voor GlobalFoundries is de productie van 3d-testchips, waarmee partners aan de slag kunnen. Die zouden dan kant-en-klare 3d-libraries kunnen gebruiken om hun producten te ontwikkelen.

:strip_icc():strip_exif()/i/2003043920.jpeg?f=fpa_thumb)
:strip_exif()/i/2003123428.jpeg?f=fpa)
/i/1390583020.png?f=fpa)
/i/1235034622.png?f=fpa)
/i/1240844012.png?f=fpa)
:strip_exif()/i/1287495336.jpeg?f=fpa)
/i/1349782684.png?f=fpa)
:strip_exif()/i/1257241493.gif?f=fpa)
