TSMC, sinds kort 's werelds grootste chipfabrikant, heeft een nieuwe methode ontwikkeld om chips te verpakken. De nieuwe Wafer-on-Wafer-techniek stapelt dies, of chips, op waferniveau op elkaar.
Chipfabrikanten zijn continu op zoek naar meer rekenkracht in steeds kleinere oppervlakten. Bij geheugen als ram en nand worden lagen al langere tijd op elkaar gestapeld en met zogeheten tsv's met elkaar verbonden. Die through silicon via's zijn metaalverbindingen die door extreem kleine gaatjes in een die, ofwel een stukje silicium worden aangebracht. Elektrische signalen kunnen door die metalen paaltjes chips met elkaar verbinden.
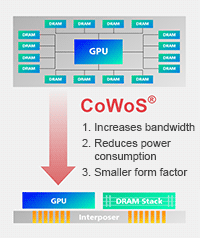 TSMC heeft al twee technieken om dergelijke 2,5- en 3d-verpakkingen van verscheidene die's in een chip te maken. De eerste is een techniek die chip on wafer on substrate genoemd wordt en verscheidene die's met een interposer verbindt. De tweede is TSMC's variant op fanout wafer-level packaging die door het bedrijf Integrated Fanout wordt genoemd en chips in epoxy met elkaar verbindt, zonder interposer of tsv's.
TSMC heeft al twee technieken om dergelijke 2,5- en 3d-verpakkingen van verscheidene die's in een chip te maken. De eerste is een techniek die chip on wafer on substrate genoemd wordt en verscheidene die's met een interposer verbindt. De tweede is TSMC's variant op fanout wafer-level packaging die door het bedrijf Integrated Fanout wordt genoemd en chips in epoxy met elkaar verbindt, zonder interposer of tsv's.
Daar is een derde 3d-verpakkingsmethode bij gekomen, die Wafer-on-Wafer is genoemd. Daarbij worden twee wafers boven op elkaar geplakt, waarbij de metalen interconnectlaag van de ene chip direct verbonden wordt met dezelfde laag van de omgekeerde wafer erbovenop. Omdat die beol-laag, de metaallaag met interconnects, ook voor de contactpunten om de chip aan te sluiten zorgt, worden tsv's ingezet om die i/o naar buiten te voeren. De tsv's worden in de bovenste chip, die na het omdraaien de onderste wordt, aangebracht tijdens de chipproductie.

Omdat de die's op waferniveau met elkaar verbonden worden, is er geen optie om kapotte dies van het wow-proces uit te sluiten. Daarom gaat TSMC de techniek alleen inzetten bij producties met een hoge yield, omdat anders te veel goede dies verloren zouden gaan als ze aan een kapotte worden gekoppeld. De techniek hoeft niet beperkt te worden tot het koppelen van twee wafers, maar kan meerdere wafers op elkaar stapelen, mits de onderliggende wafers maar steeds tsv's krijgen om met elkaar te communiceren.
De rol van Cadence in deze technologie, die TSMC nog niet heeft aangekondigd, maar wel bij Cadence is uitgelegd, is die van leverancier van chipontwerptools en packaging tools. Zowel tijdens het chipontwerp als bij de verpakking van de die tot een functionele chip zijn dergelijke tools nodig en bedrijven als Cadence werken dan ook nauw samen met chipproducten.

:strip_exif()/i/2005671266.jpeg?f=fpa)
:strip_exif()/i/2003123428.jpeg?f=fpa)
/i/2001665377.png?f=fpa)
/i/2001543927.png?f=fpa)
/i/1304670251.png?f=fpa)
/i/1309767168.png?f=fpa)
/i/1242207182.png?f=fpa)